酸化ガリウム (Ga2O3) トランジスタ、ダイオード
現在、世界的な課題として、化石燃料に替わる新エネルギーの創出と並行して、革新的な省電力技術の開発が求められています。このような社会事情から、現状のシリコン(Si) よりも更に高耐圧・低損失なパワーデバイスの実現が期待できるSiC, GaNといったワイドギャップ半導体材料が注目され、日本はもとより米国、欧州といった諸外国においても活発に研究開発が進められています。酸化ガリウム(Ga2O3) は、約4.8 eVとその非常に大きなバンドギャップに代表される物性から、SiC, GaNに代表される既存のワイドギャップ半導体と比較しても、更に上を行くだけの大きなポテンシャルを秘めており、パワーデバイス用途に非常に有望であると期待されます。また、単結晶バルクを融液成長法により作製可能であることから、大口径高品質基板が低コストで得られる点も大きな魅力であります。しかし、これらの高い材料的ポテンシャルにもかかわらず、これまで研究開発はほとんど手付かずの状態でありました。
我々は現在、世界に先駆けてGa2O3トランジスタ、ダイオードの開発に、企業、大学の共同研究者とともに挑んでおります。2010年研究開発からの短い期間で、すでにいくつかのブレークスルーを成し遂げ、パイオニアとしてこの新しい半導体材料・デバイス分野をリードしております。
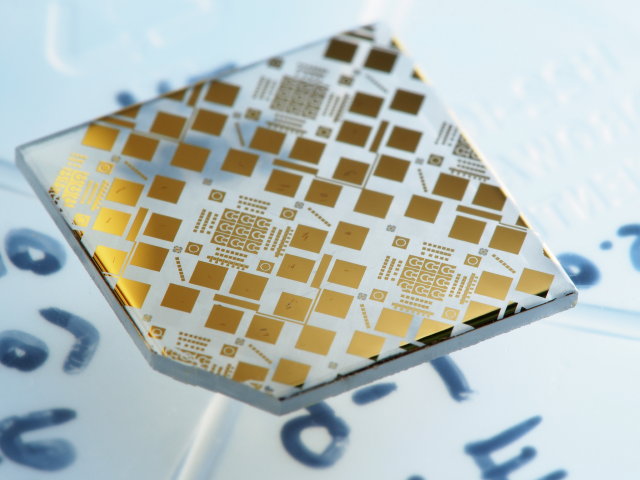

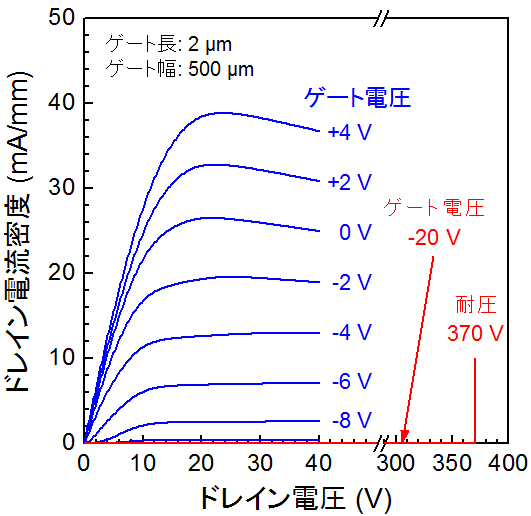
Ga2O3トランジスタを作製したチップ 4インチGa2O3基板(タムラ製作所提供) Ga2O3 MOSFETの電流―電圧特性
III族酸化物/窒化物複合構造の形成とそのデバイス応用
Ⅲ族酸化物半導体(Ga2O3, Al2O3, In2O3)と窒化物半導体(GaN, AlN, InN)を構成材料とするヘテロ構造を作製し、物性、光学的、電気的特性を評価し、最終的に新規半導体デバイス実現へとつなげることを目的とします。大きく分けて二つのタイプ(タイプ1、2)の酸化物・窒化物ヘテロ構造の実現に挑みます。タイプ1は、窒化物半導体(主にGaN)をチャネル層とし、酸化物(主にAl2O3)を障壁層とする構造、タイプ2は、酸化物半導体(主にGa2O3)をチャネル層に、窒化物(主にAlN)を障壁層とする構造になります。タイプ1では、GaNヘテロ構造トランジスタ(HFET)のデバイス特性、信頼性の改善につなげることを主な目的とします。また、タイプ2では窒化物障壁層内の分極を利用することで、高密度二次元電子ガスチャネルを誘起した、これまでに例を見ない窒化物/酸化物HFETの実現を目指します。
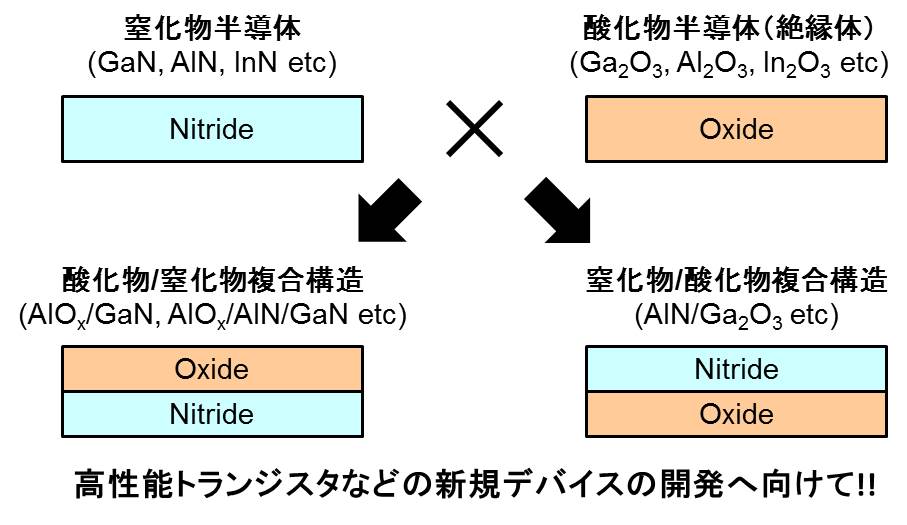 酸化物/窒化物ヘテロ構造の概念図
酸化物/窒化物ヘテロ構造の概念図
